[ad_1]

Tras la presentación en mayo por parte de la doctora Lisa Su de su nueva tecnología 3D para Ryzen Zen 3 mucho se ha hablado de todo lo relacionado con el sistema de conexión por parte de TSMC. La realidad es que no había demasiada información disponible, pero ahora se ha desvelado una pequeña parte de esta 3D Caché de AMD, la cual impulsará sin duda el rendimiento hasta tal punto que superará a Intel en su sector fetiche: el gaming.
Lo que están haciendo tanto AMD como TSMC es muy impresionante, quizás no al nivel de Intel con Foveros (de momento) pero lo que es seguro es que aunque tecnológicamente no estén por ahora a la altura, en rendimiento sí que se van a posicionar líderes (salvo sorpresa con Alder Lake-S).
AMD Zen 3 3D Caché, un salto de rendimiento del 15% en gaming
Los números deslizados por Lisa Su dan como resultado promedio dicha cifra, pero ahora conocemos las curiosidades de los porqués. Y es que el añadir un chip vertical más a modo de caché aumentada no será, como se estaba especulando, una caché de nivel 4, o dicho de otro modo, no será la típica Victim Caché técnicamente hablando.
Todo es bastante más simple desde la teoría, pero desde la práctica los números son abrumadores y nos explicamos.
Lo que AMD consigue con esta caché vertical es que Windows y los CCD vean al chip añadido como «transparente», es decir, no hay un cambio físico para el software ni para el hardware en su modo de funcionamiento entre núcleos y el IOD.
Lo que verán será un bloque de caché L3 más, el cual estará fabricado a 7 nm por TSMC y medirá la friolera de 6 x 6 mm (36 mm2) conectado directamente a las cachés de los CCD mediante TSV. Y aquí llega la magia, porque en el caso del 5950X que se mostró en su momento con dicha tecnología hablamos de nada menos que 192 MB de L3 en total por los 64 existentes del modelo original que podemos comprar actualmente.
Cifras de TSV mareantes, a la altura de Intel
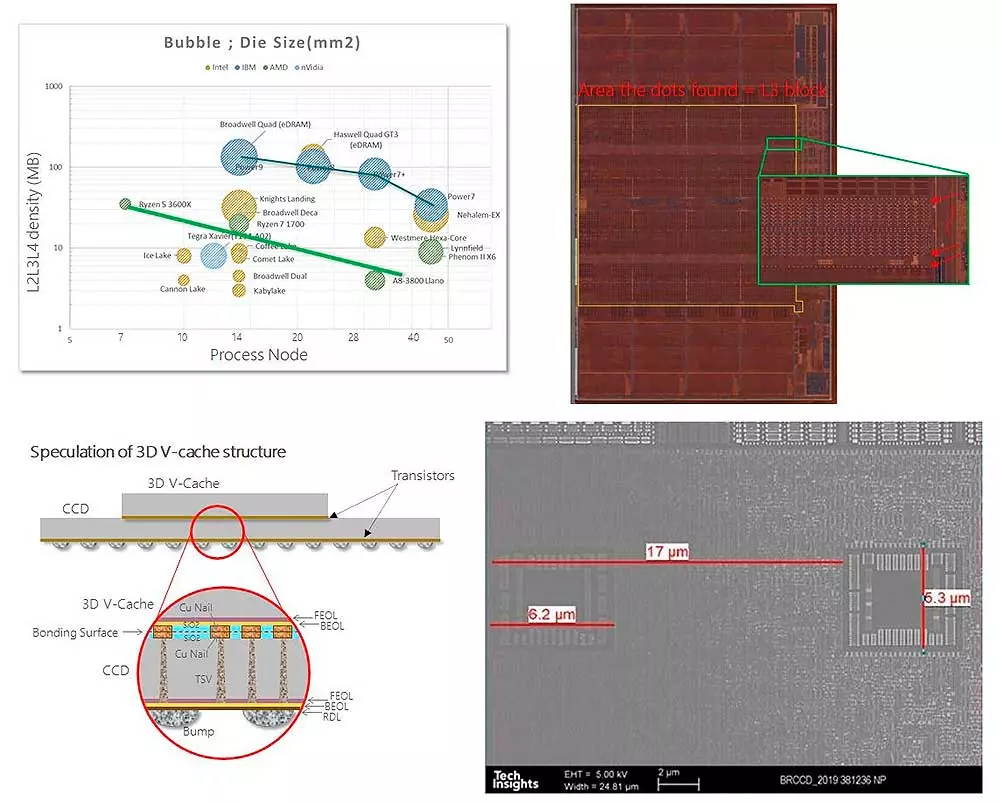
Cada CPU tendrá más de 2 TB/s de ancho de banda gracias a esta nueva caché y sus conexiones TSV, las cuales ahora sabemos que se realizan por Bumps en lo que se denomina como «Face Down», Cada TSV se conecta desde el FEOL de cada CCD hasta la Bonding Surface mediante Nails de cobre. Estas están en contacto directo con el BEOL de esta nueva caché, lo que permite el intercambio de información de los sustratos y cachés.
Para que nos hagamos una idea de la complejidad de todo este apilamiento vertical, se calcula que por cada partición de L3 de 4 MB que tiene un CCD hay 3000 TSV con un tamaño que las comprende entre los 6.1 μm y los 17.3 μm de grosor.
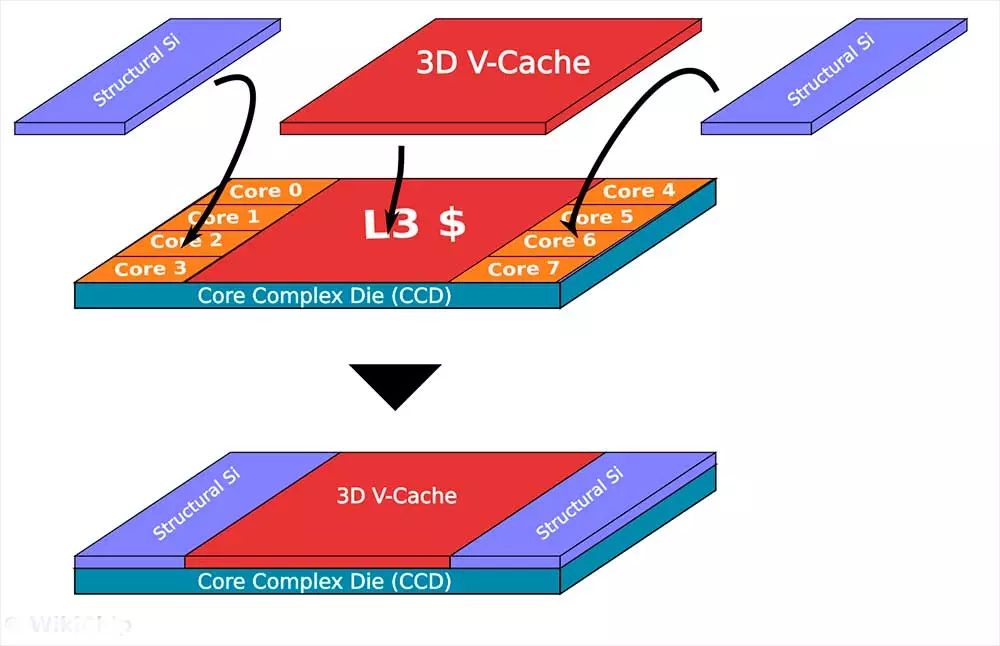
Para cuadrar el círculo se dan más datos estratosféricos, ya que en el SMU se calculan 56 TSV y 14 más en la denominada área de test.
¿Qué tenemos en total en el nuevo 5950X? Pues la friolera de 24070 TSVs para conectar ambos sustratos, donde como hemos dicho antes el área de la nueva Caché 3D de AMD es de solo 36 mm2. Sin duda cifras apabullantes y que van a permitir que AMD golpee a Intel hasta tumbarlo, al menos momentáneamente.
The post Por esto AMD va a superar este año a Intel en las CPU para juegos appeared first on HardZone.
[ad_2]
